导读 先进半导体技术的全球领导者三星电子今天宣布,其经硅验证的 3D IC 封装技术 eXtended-Cube (X-Cube) 可立即用于当今最先进的工艺节
先进半导体技术的全球领导者三星电子今天宣布,其经硅验证的 3D IC 封装技术 eXtended-Cube (X-Cube) 可立即用于当今最先进的工艺节点。利用三星的硅通孔 (TSV) 技术,X-Cube 在速度和能效方面实现了重大飞跃,有助于满足下一代应用的严格性能需求,包括 5G、人工智能、高性能计算以及移动和可穿戴。
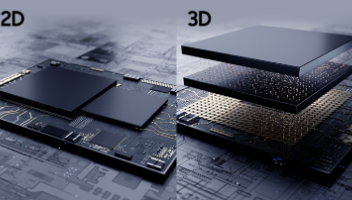
三星电子代工市场战略高级副总裁 Moonsoo Kang 表示:“三星新的 3D 集成技术即使在尖端的 EUV 工艺节点也能确保可靠的 TSV 互连。“我们致力于带来更多可以突破半导体界限的 3D IC 创新。”
*显示的图像仅用于说明目的。
借助三星的 X-Cube,芯片设计人员可以更加灵活地构建最适合其独特需求的定制解决方案。基于 7nm 的 X-Cube 测试芯片使用 TSV 技术在逻辑芯片顶部堆叠 SRAM,释放空间以将更多内存装入更小的占位面积中。通过 3D 集成,超薄封装设计的特点是显着缩短了管芯之间的信号路径,以最大限度地提高数据传输速度和能源效率。客户还可以将内存带宽和密度扩展到他们想要的规格。
三星 X-Cube 经过硅验证的设计方法和流程现已可用于包括 7nm 和 5nm 在内的高级节点。在初始设计的基础上,三星计划继续与全球无晶圆厂客户合作,以促进 3D IC 解决方案在下一代高性能应用中的部署。